 |
 |
大気圧プラズマCVD(Atmospheric
Pressure Plasma Chemical Vapor Deposition) |
 |
|
 |
 [各図をクリックすると別ウインドウで拡大図が表示されます] [各図をクリックすると別ウインドウで拡大図が表示されます]
大気圧プラズマCVD法は、大気圧という高圧力雰囲気において、高速回転する電極と基板との間で高周波プラズマを発生させ、高密度に生成されたラジカルを利用する新しい高速成膜法です。
減圧下での希薄な雰囲気における従来のプロセスと異なり、成膜速度、および膜の均質性を大幅に向上させることが可能です。また、プロセスガスを循環させることで、プラズマ中で生成するパーティクルを除去できるので、膜質の劣化を防ぎ、高品質な薄膜の形成が可能です。
|
 |
| 現在、産学一体となった共同研究体制のもとに、太陽電池や液晶ディスプレイに用いられる高性能なアモルファスSi(a-Si)薄膜や多結晶Si(Poly-Si)薄膜、半導体デバイス基板用のエピタキシャルSi薄膜、さらにSiCやSiN、ダイヤモンド等の超高速成膜技術の開発を進めています。 |
 |
写真1は、本研究で開発した大気圧プラズマCVD装置です。徹底的なクリーン化対策と超高純度ガスの利用により、高品質な機能薄膜の高速形成が可能となっています。
本成膜法では、従来の低圧プラズマCVDに対して約10倍の成膜速度(1m×1m基板換算)で発電層のa-Si薄膜を形成した太陽電池デバイスの作製に成功しています。種々の検討結果から、大気圧プラズマCVDを太陽電池製造プロセスに適用できる見通しが得られています。
また、図1は本成膜法によりエピタキシャルSi薄膜を高速形成した一例です。現在エピタキシャルSiウエハの製造に用いられている熱CVDに対して、20倍の高速成膜と200℃の低温化を実現しています。 |
 |
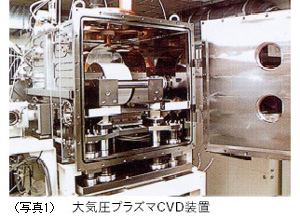
|
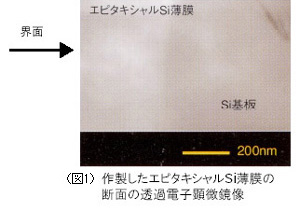 |
 |
 |

