|
 |
 |
極微弱光散乱表面計測法 |
 |
|
 |
 [各図をクリックすると別ウインドウで拡大図が表示されます] [各図をクリックすると別ウインドウで拡大図が表示されます]
シリコンウエハ上のパーティクルの直径をナノメータオーダーで測定できる光散乱粒径測定装置を開発しています。右図に示すように、集束レーザー光をシリコンウエハ上で走査し、そのスポット光内をパーティクルが通過すれば、粒径に応じた強度の散乱光が生じます。この散乱光のみを光電子増倍管と
CR積分回路により積分電圧として検出すれば、その波高値から粒径をナノメ−タオ−ダーで測定できます。
現在市販されているパーティクルカウンタは粒径 80 nm以下のパーティクルを検出することができませんが、本測定機では迷光を削減し、楕円面鏡により全散乱光を集光することにより、粒径
15 nm相当の散乱光までが測定可能です。また、パーティクルカウンタでは検出できないスクラッチやマイクロラフネス等の表面ナノ構造も同時に計測できます。 |
 |
右図は直径8インチのシリコンウエハに対する市販のパーティクルカウンターによる測定結果です。その一部の5mm×5mm領域を本測定機により計測した結果を下図に示します。右図に示すようにパーティクルカウンターでは粒径90nm程度のパーティクルを2個しか検出できておりませんが、下図に示すように本測定機はパーティクルカウンターでは検出できない粒径80nm以下のパーティクルを多数計測できており、同時に幅10nm以下のスクラッチ状の表面ナノ構造を計測できています。
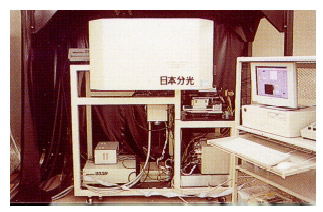 |
 |
 |
 |
|

